熱硬化型絕緣增層膜
NX04H, NQ07XP
應用例
積水的絕緣增層膜被廣泛使用在需求低損耗低翹曲高階的IC封裝基板中
憑藉實現更低損耗和更優可靠性,積水的絕緣增層膜可以大大提高封裝的設計彈性

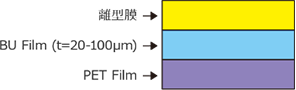
What is Build-up Dielectric (BU) Film
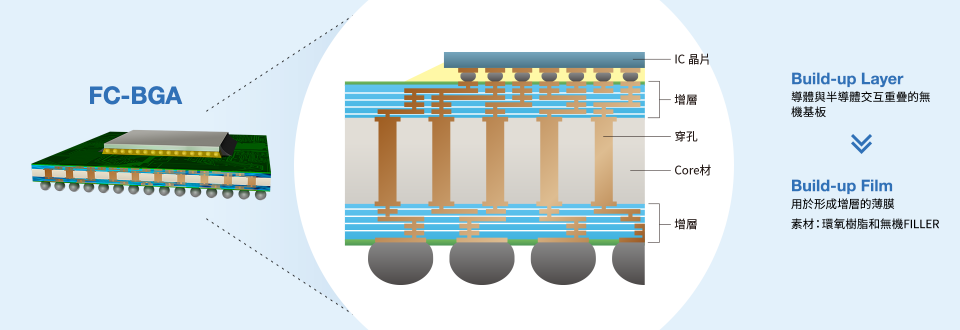
Buid Up Film是一種在IC載板中形成精密線路的絕緣增層膜
優勢
積水的絕緣增層膜能夠對應半加成法(SAP)製程,並有寬裕穩定的製程調整範圍
大多的主要日台IC載板廠商以及封測廠(OSAT)都和積水在絕緣增層膜上擁有廣泛的合作
Semi-Additive Process (SAP)

若您需要詳細的半加成法(SAP)製程參數與產品情報請聯繫我們
Current Product Lineup
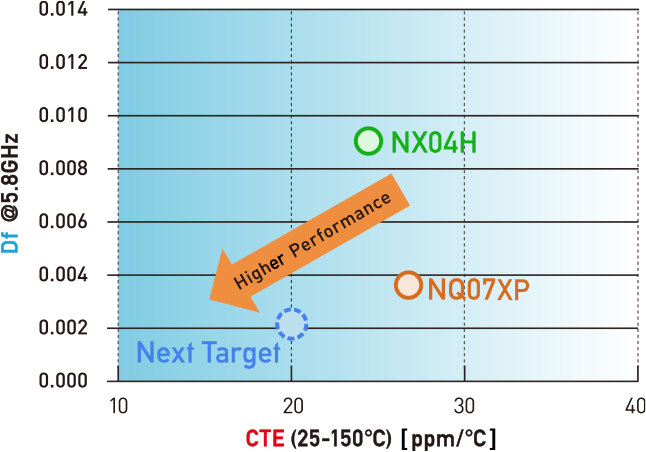
| NX04H (HVM) |
NQ07XP (LVM) |
Next Target (Under Development) |
|
|---|---|---|---|
| CTE (25-150°C) [ppm/°C] | 24.5 | 27 | 24 |
| CTE (150-240°C) [ppm/°C] | 70 | 94 | 82 |
| Dk (5.8GHz) | 3.3 | 3.3 | 3.3 |
| Df (5.8GHz) | 0.0090 | 0.0037 | 0.0023 |
| Tensile Strength [MPa] | 100 | 105 | 110 |
| Young’s Modulus [GPa] | 8 | 10 | 12 |
| Tg (DMA) [°C] | 205 | 183 | 183 |
| Elongation [%] | 2.4 | 2.6 | 2.6 |
| Ra (WYKO) [nm] | 50 | 50 | 50 |
| Available Thicknesses [μm] | > 20 | > 20 | > 20 |
| Flame Retardant (UL94) | V0 | V0 | ( V0 ※yet to be certified) |
| Applications | Package Substrates for CPU, Networking, PCIe Switch devices and more | ||
技術
通過結合積水自身的化學配方技術和塗工技術,積水絕緣增層膜同時實現LOW DF,蝕刻後保持均一低表面粗糙度、並有高彎折強度。
通過以上這些特性,為下一世代的IC載板貢獻傳送損失更低、線路更細、並且維持高製造良率的特性
此外,積水作為一個優質膠帶&膜類供應商會提供多種厚度的絕緣增層膜去滿足市場的需求
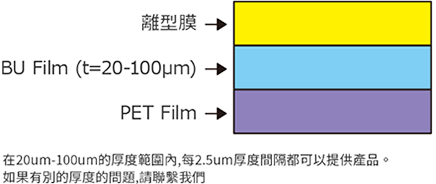
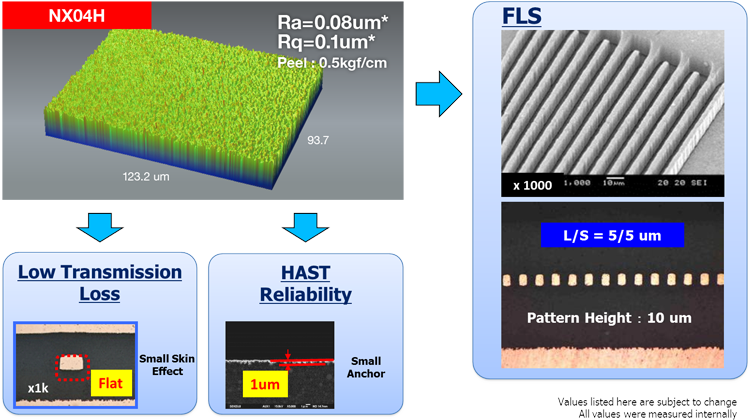
我們絕緣增層膜的客戶
Future
積水 正在開發新的熱硬化型絕緣增層膜,它將成為未來高速通信所需的各種技術問題的解決方案。
有任何開發需求請聯絡我們
